汽车中应用广泛,是汽车动力总成系统高效、快速、稳定、安全能量变换的基础。新能源汽车中器。用于实现大功率直流/交流变换之后驱动电动机,还可用于捕获再生制动能量并回馈给电池组,是新能源汽车的“心脏”,决定了汽车的功能安全性,高速平稳性和绿色舒适性。
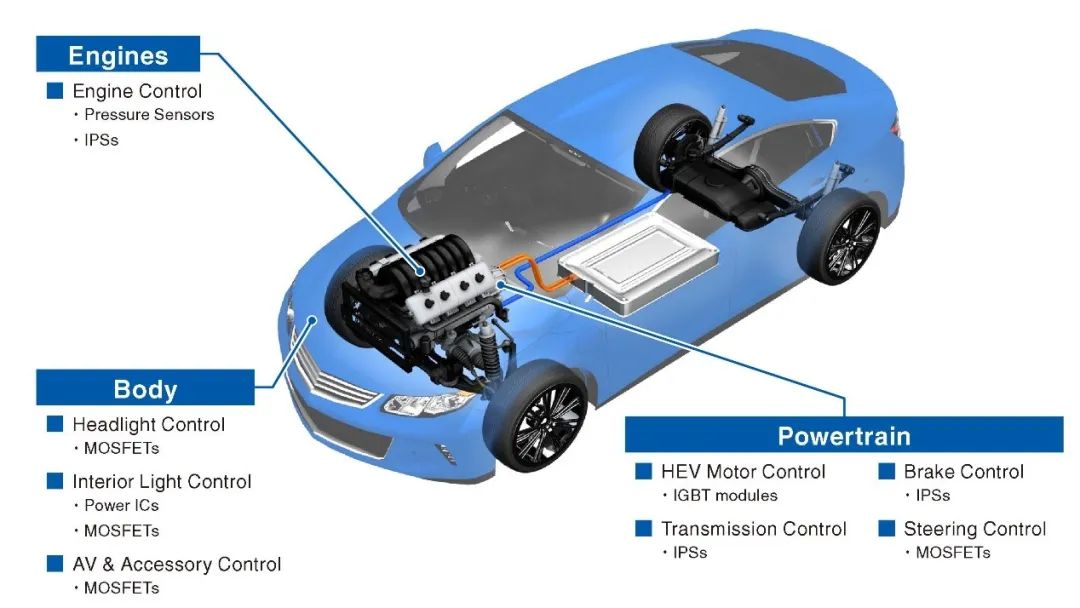
由于新能源汽车对续航里程的高需求,使得电能管理需求更精细化,这些对绝缘栅双极晶体管(Insulated Gate Bipolar Transister,IGBT)、MOSFET二极管等功率分立器件的需求远高于传统汽车,在新能源汽车中功率半导体占了整车半导体的55%左右。
功率半导体器件作为电能转换、驱动、控制等电力电子装置的基础和核心,是推动电力电子系统转化效率、功率密度、体积重量等方面优化的重要的条件之一。
下面来看看功率半导体IGBT的分布,其中红色为后置发动机,绿色为前置发动机。机舱地板下方是四个电池组。逆变器(蓝色)集成在电机外壳中,并与其共享冷却回路。逆变器将电池的直流电转换为电机交流电,也是IGBT模组安装的地方。
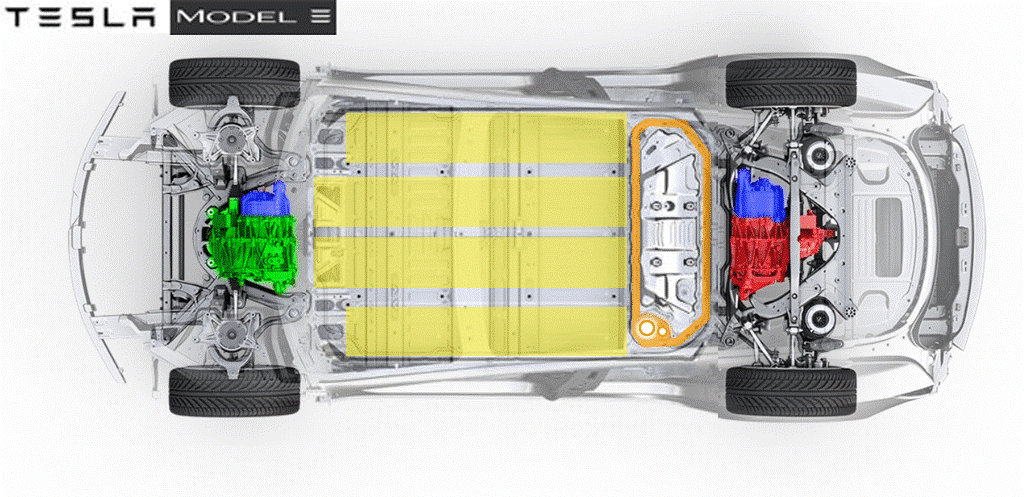

动力装置爆炸拆解图,这中间还包括电机(定子和转子),传动部分(齿轮),和控制部分(逆变器):
下面这张图就是本文要讲解的重点了——逆变器!也就是功率器件IGBT安装的位置:


1946年1月,远在太平洋彼岸的美国BELL实验室正式成立了一个半导体研究小组,小组内有3名核心成员,分别是Schokley、Bardeen和Brattain,俗称“晶体管三剑客”。
三剑客有自己的研究优势,Bardeen提出了表面态理论,Schokley给出了实现放大器的基本设想,Brattain设计了实验。
在三剑客成立的次年,1947年巴丁(Bardeen)和布莱登(Brattain)发明了点接触(point‒contact)晶体管。接着在1949年肖克莱(Shockley)发表了关于p‒n结和双极型晶体管的经典论文。有史以来的第一个晶体管中,在三角形石英晶体底部的两个点接触是由相隔50μm的金箔线压到半导体表面做成的,所用的半导体材料为锗;当一个接触正偏(forward biased,即对于第三个端点加正电压),而另一个接触反偏(reverse biased)时,可以观察到把输入信号放大的晶体管行为(transistoraction)。
既然说IGBT集成BJT和MOSFET的优点于一身,那么什么是BJT,什么是MOSFET呢?
半导体应用离不开硅元素,来看一下硅元素的特点,在元素周期表中,硅排列在第14位,硅原子最外层有4个电子,分别与周围4个原子共用4对电子,这种共用电子对的结构称为共价键(covalent bonding)。每个电子对组成一个共价键。这部分知识初中化学学过,来张图片直观看看:

左边这张图是单晶硅的晶体结构,为金刚石晶体结构。右边这张图是硅原子共用电子的情况,中间一个硅原子和四个硅兄弟共用电子。
突然有一天,物理学家想到一个问题,要是硅家不是和硅兄弟共用电子,把其他兄弟拉进群会怎样?物理学家有一天把砷兄拉进了群,于是奇迹发生了:

砷兄弟最外层有5个电子,其中4个电子找到了硅家的对象,另外一个电子单着了,这个电子成了无业游民,到处流窜,由于电子带有电荷,于是改变了硅家的导电性。此时的砷原子多提供了一个电子给硅家,因此砷原子被称为施主。
硅家的自由电子多了以后,带负电的载流子增加,硅变成n型半导体。为啥叫N型?在英文里Negative代表负,取这个单词的第一个字母,就是N。 同样,物理学家想,既然可以拉电子多的砷元素进群,那么是否也可以拉电子少的硼原子进群?于是物理学家把硼原子拉进来试试。

由于硼原子最外层只有3个电子,比硅少一个,于是本来2对电子的共价键现在成了只有一对电子,多了一个空位,成了带正电的空穴(hole)。此时的硅基半导体被称为p型半导体,同样P来自英文单词Positive(正极)的首字母,而硼原子则被称为受主。
举个例子,P型半导体是一块正方形的泥巴,这个泥巴里有很多孔洞(空穴),类似于我们正真看到的龙虾洞。N型半导体也是一块正方形的泥巴,这个泥巴中藏了很多龙虾(自由电子)。当我们把这两块泥巴贴在一起的时候,龙虾就会往龙虾洞的方向爬(电子漂移)。在电子的漂移下,PN结中形成电流。
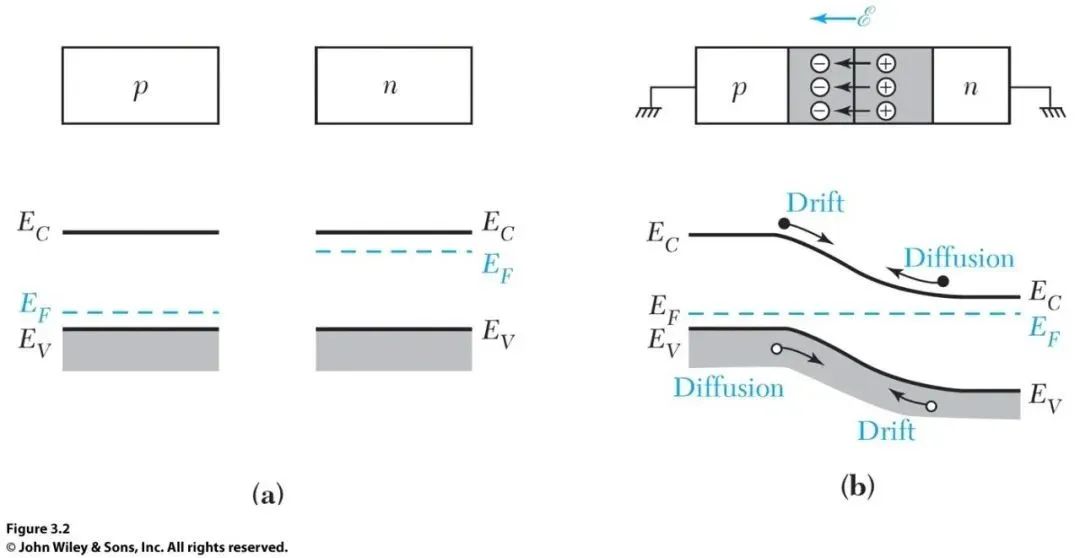
再说一说晶体管的功能,晶体管(transistor,是转换电阻transfer resistor的缩写)是一个多重结的半导体器件。通常晶体管会与其他电路器件整合在一起,以获得电压、电流或是信号功率增益。
在电路中晶体管的最大的作用是当作开关。可利用小的基极电流在极短时间内改变集电极电流由关(off)成为开(on)(反之亦然)。关是高电压低电流,开是低电压高电流。
双极型晶体管(bipolar transistor)的结构:双极型器件是一种电子与空穴皆参与导通过程的半导体器件,由两个相邻的耦合p‒n结所组成,其结构可为p‒n‒p或n-p-n的形式。
下图为p‒n‒p双极型晶体管的透视图,其制作的完整过程是以p型半导体为衬底,利用热扩散的原理在p型衬底上形成一n型区,再在此n型区上以热扩散形成一高浓度的p+型区,接着以金属覆盖p+、n以及下方的p型区形成欧姆接触。
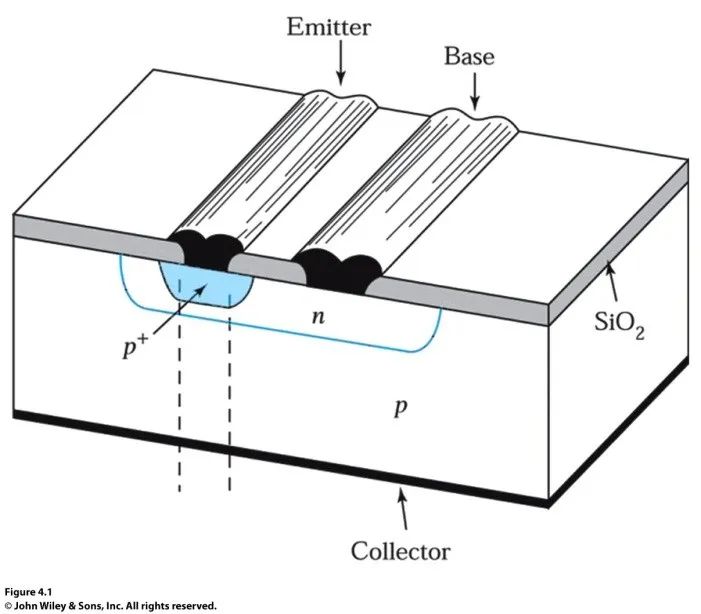
下图为p‒n‒p双极型晶体管,具有三段不同掺杂浓度的区域,形成两个p‒n结。浓度最高的p+区称为发射区(emitter,以E表示);中间较窄的n型区域,其杂质浓度中等,称为基区(base,用B表示),基区的宽度需远小于少数载流子的扩散长度;浓度最小的p型区域称为集电区(collector,用C表示)。各区域内的浓度假设均匀分布,p‒n结的概念可直接应用在晶体管内的结上。
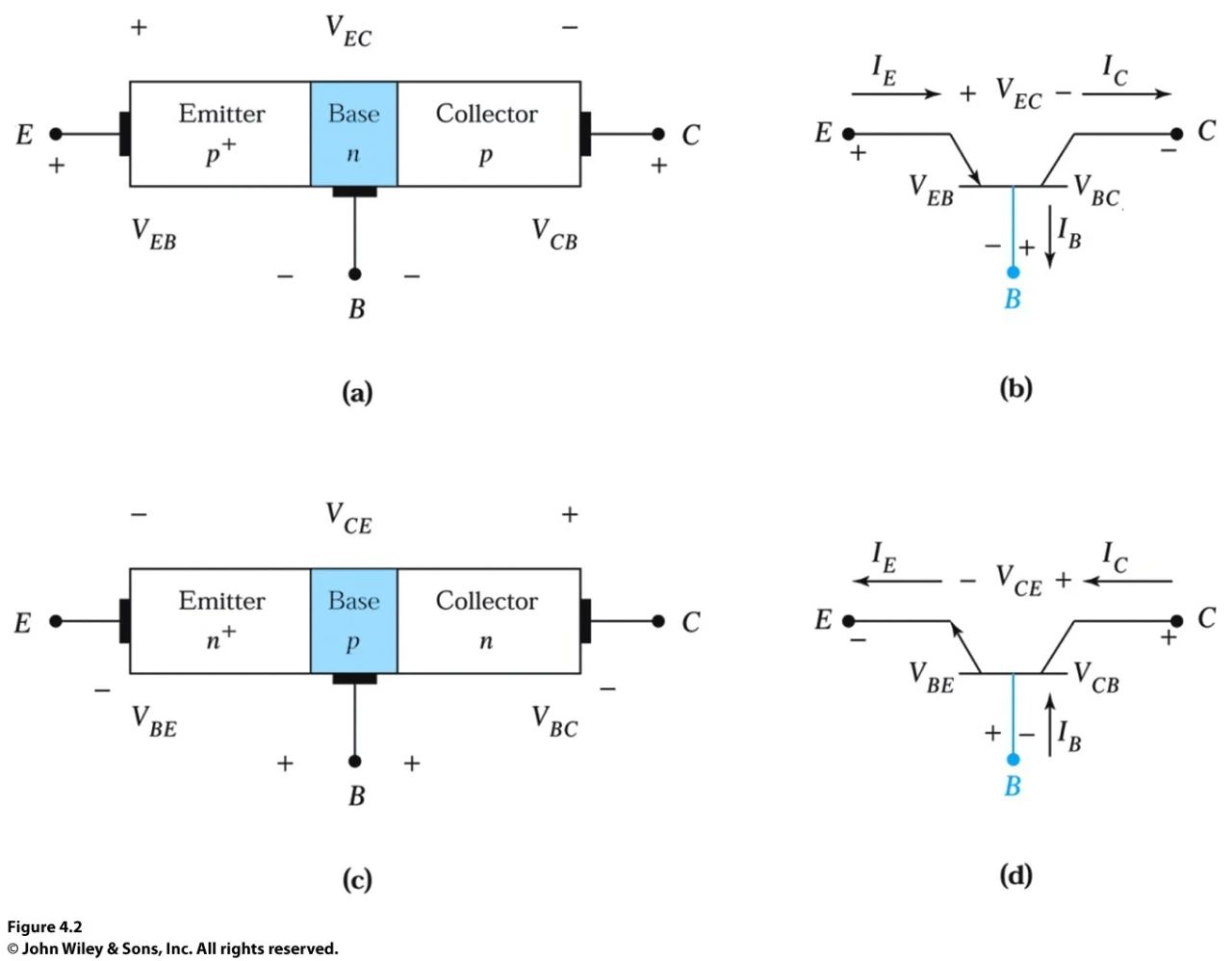
了解了BJT后,再来了解下MOSFET的定义。先了解MOSFET的前半部分,也就是MOS器件。
金属‒氧化物‒半导体(MOS)电容在半导体器件中占有重要的地位,它是研究半导体表面特性最有用的器件之一,它也是先进集成电路中最重要的MOSFET器件的枢纽。
理想MOS电容:MOS电容的透视结构如下图所示,为其剖面结构,其中d为氧化层厚度,而V为施加于金属平板上的电压。当金属平板相对于欧姆接触为正偏压时,V为正值;而当金属平板相对于欧姆接触为负偏压时,V为负值。
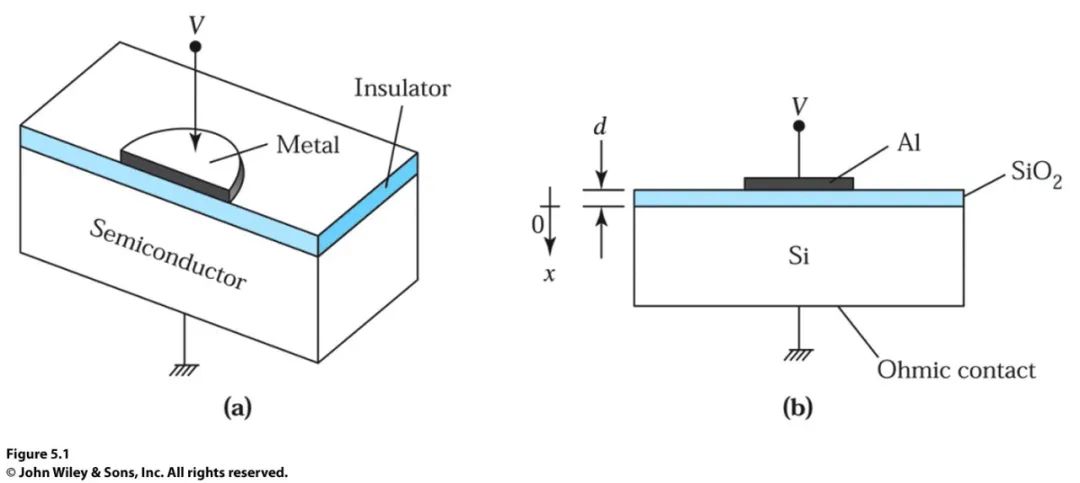
n沟道MOSFET如下图,它是一个四端点器件,由一个有两个n+区域(即源极与漏极)的p型半导体组成。对于p沟道MOSFET,衬底和源、漏区的掺杂类型分别为n和p+。
氧化层上的金属称栅极(gate),高掺杂或结合金属硅化物如WSi2的多晶硅可作栅电极,第四个端点为连接至衬底的欧姆接触。
基本器件参数有沟道长度L(两个n+‒p结间的距离)、沟道宽度Z、氧化层厚度d、结深度rj以及衬底掺杂浓度NA。器件中央即为MOS电容。
MOSFET的基本特性:MOSFET中源极接点作为电压参考点。栅极无外加偏压时,源极到漏极电极间可视为两个背靠背相接的p‒n结,而由源极流向漏极的电流只有反向漏电流。
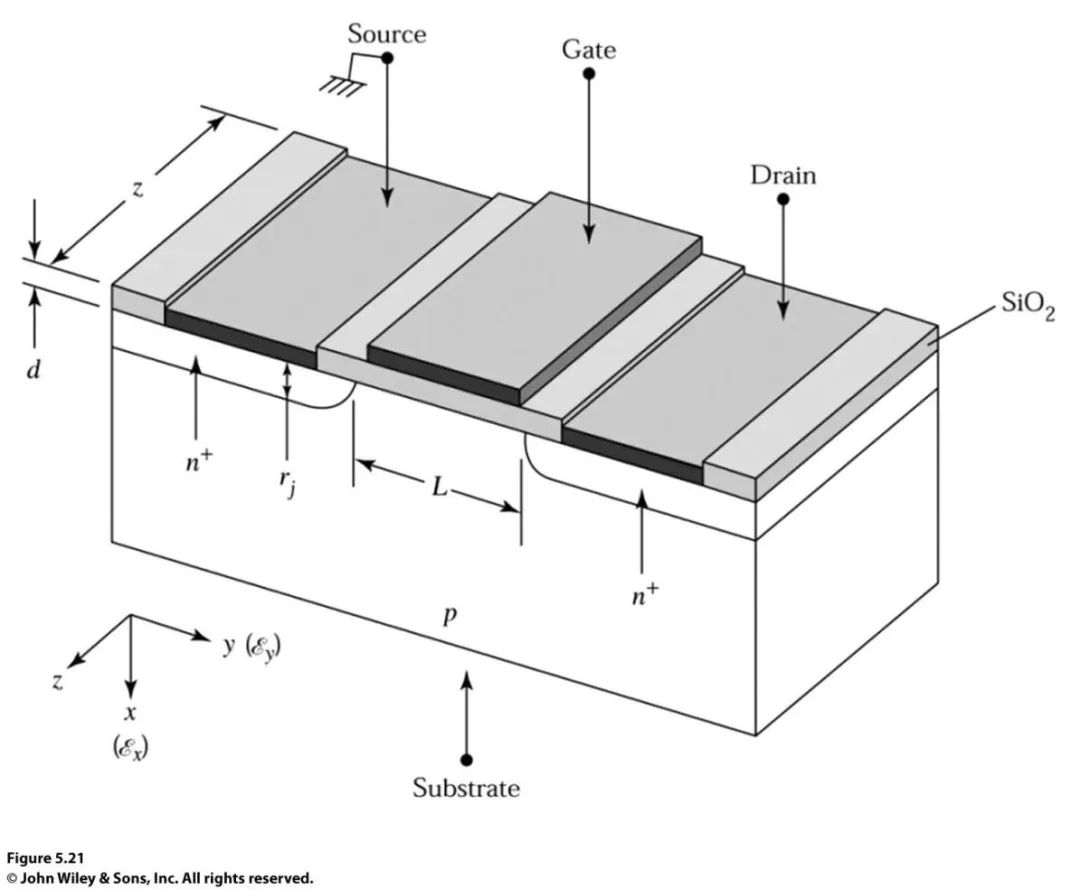
这些定义读起来有些绕口,总体功能类似与一个水龙头开关,能控制水流流向及大小,在内部结构上,能够最终靠下图来看MOSFET、BJT及IGBT内部结构差异:
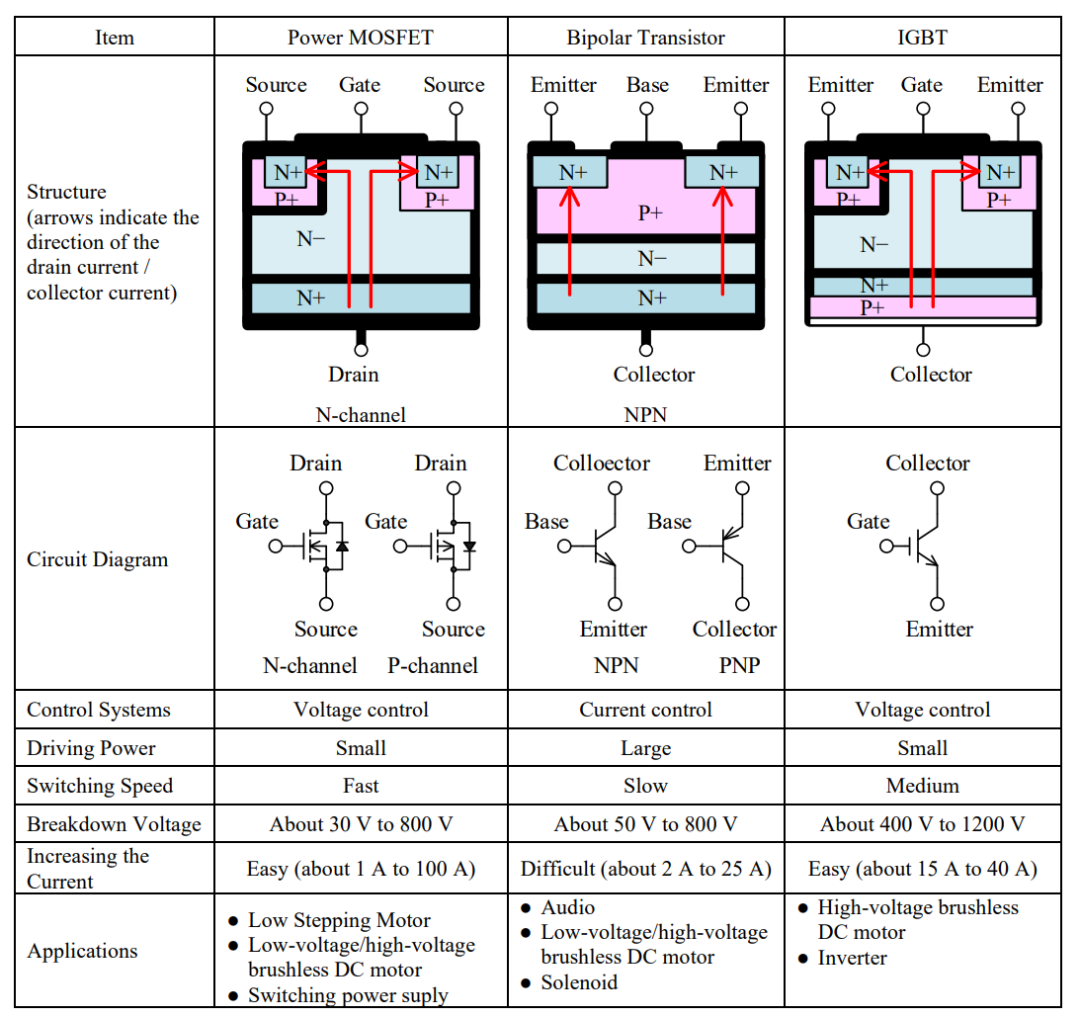
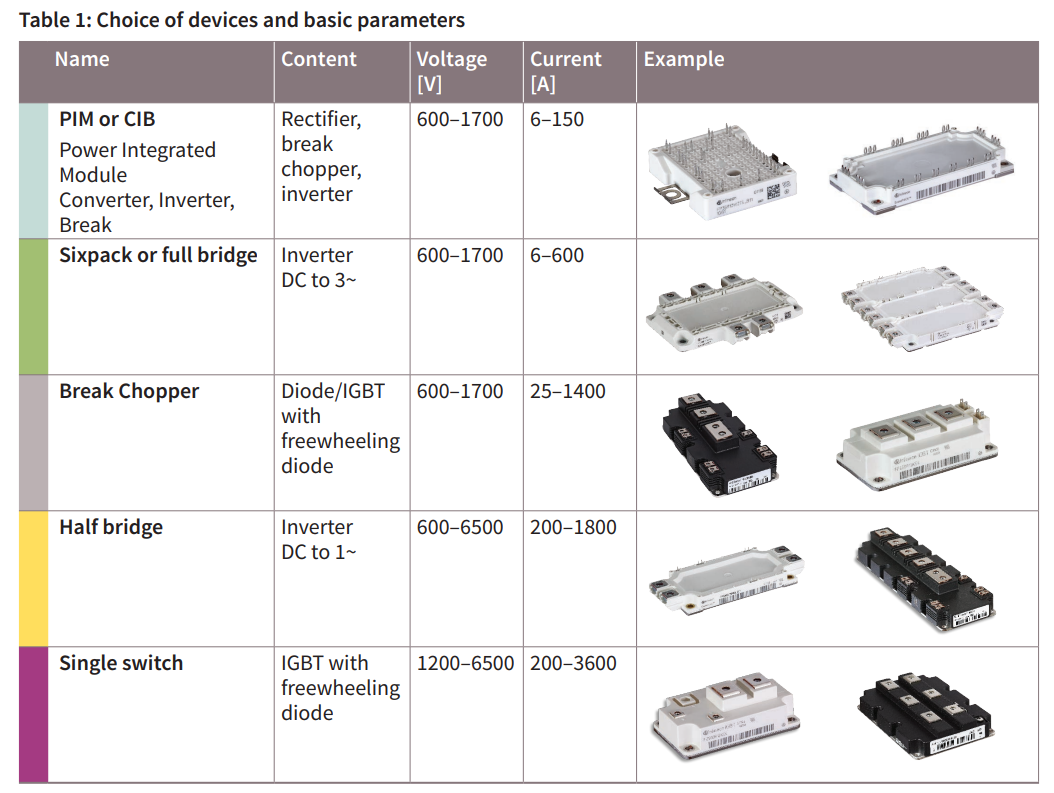
对其中一款IGBT模块进行拆解,IGBT模块内部结构如下图所示,在制作的完整过程中主要可大致分为两部分,一部分是IGBT芯片的封装及测试,另一部分是IGBT芯片的设计及制造:
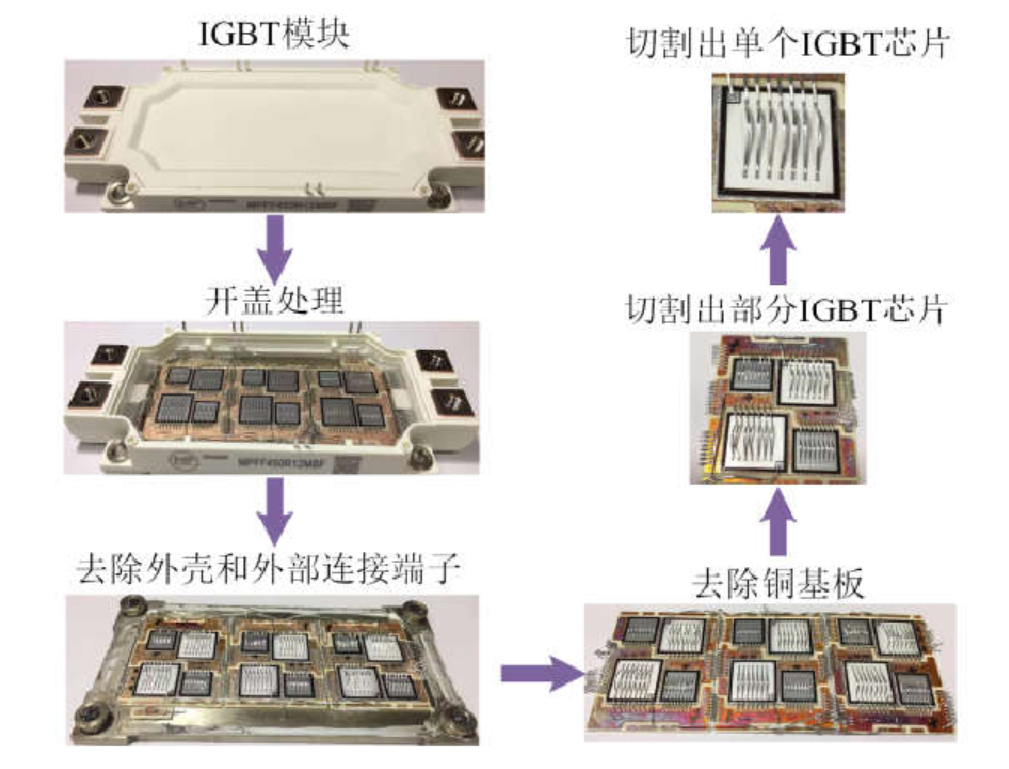

(1)芯片:包括IGBT芯片和二极管芯片,它们是IGBT模块的核心结构。
(2)直接敷铜陶瓷基板(DirectCopperBonded,DCB):包括上铜层、陶瓷基板层和下铜层三个部分。上铜层的正面依据需求刻蚀成了电路,可以为IGBT芯片的集电极、发射极和栅极等电极提供中转以及互连。陶瓷基板层常采用氧化铝或者氮化铝材料制造成,它主要是为芯片和其下部的结构层提供绝缘,同时为芯片和上铜层提供支撑和散热。下铜层的最大的作用是为各个芯片提供散热路径。
(4)焊料层:主要起到了连通芯片、直接敷铜陶瓷基板的上铜层、直接敷铜陶瓷基板的下铜层和铜基板的作用。
(5)Al键合线:一般会用多根并联的方式,键合线一端键合于芯片上,另一端键合于直接敷铜陶瓷基板的上铜层。Al键合线的最大的作用是实现芯片与外部连接端子之间的互连。
(6)Al金属化层:具有延展性好,导电性能优等特点,促成了IGBT芯片与Al引线)外部连接端子:包括发射极母排和集电极母排,它们一端跨接在直接敷铜陶瓷基板的上铜层,另一端于器件外部,主要实现IGBT芯片与外部电路的互连。
(8)硅胶:用于保护各互连结构层免受外部酸碱腐蚀,同时能保护各互连结构层免受振动冲击。
(9)外壳:包括由环氧树脂制成的侧框和上部的管盖,可保护IGBT模块内部的互连结构层免受外部环境的影响。
的外观及截面如下图所示,其中上铜层布置功率半导体/二极管芯片/键合线等电气部分,由DBC提供电路布局、绝缘、传热、机械支撑等功能,散热基板向上支撑衬板,向下与散热介质接触。传热路径上主要部件依次为功率芯片、芯片焊料、上铜层、陶瓷、下铜层、DBC焊料与基板。
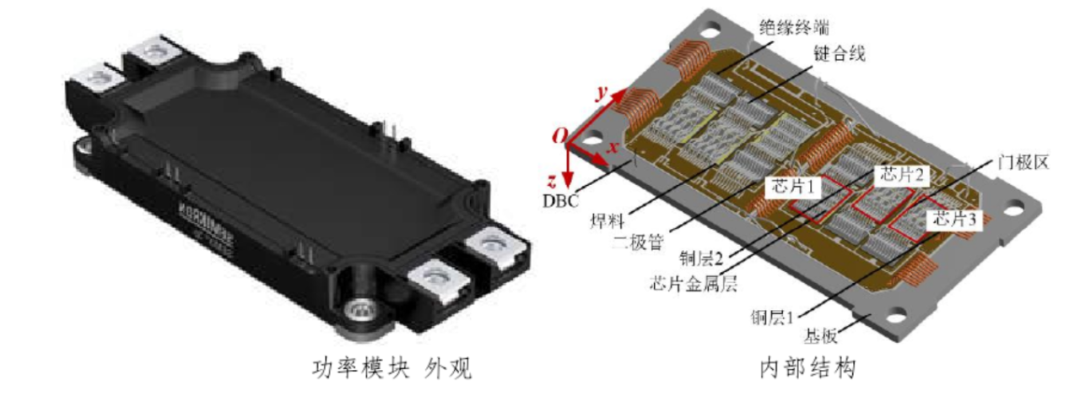
下图是一款IGBT模块的内部结构,在IGBT模块内部集成了6个IGBT芯片,分别命名为IGBTⅠ、Ⅱ、Ⅲ、Ⅳ、Ⅴ、Ⅵ。这6个IGBT芯片分为上、下两个半桥臂,其中,IGBTⅠ、Ⅱ、Ⅲ并联连接组成上半桥臂,IGBT Ⅳ、Ⅴ、Ⅵ并联连接组成下半桥臂,两个半桥臂之间串联连接。每个IGBT芯片的两端反并联有1个二极管,用于实现续流。
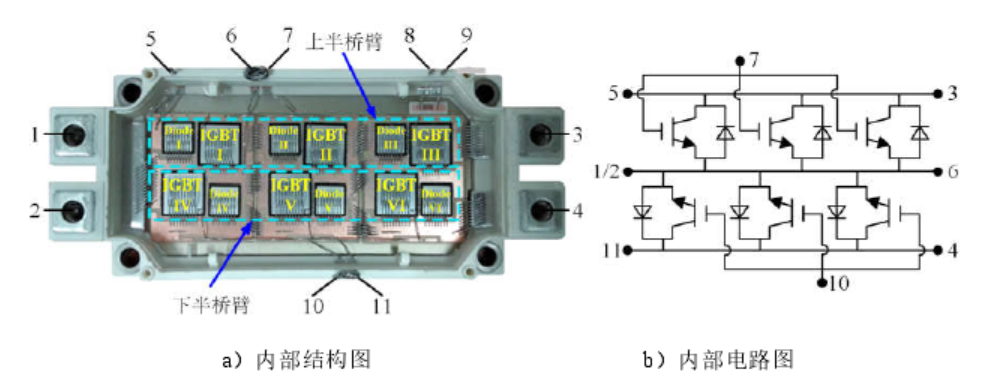
在解决IGBT封装问题上,大部分精力集中在解决IGBT模块的散热上,毕竟任何功率器件在温度过高的环境下更容易老化失效。
在IGBT的封装结构优化上,主要从两方面做了考虑,一方面就是封装过程中引线键合方式,俗称绑定(英文Bonding的读音),另一方面就是芯片的布局方式优化。
在引线键合方式的优化上,绑定落点数量的增加有利于降低芯片金属层中落点周围的电流密度,当新增一个落点后,芯片金属层的最大电流密度降低了20%,这使得功率循环性能提高了4倍。自此,多落点绑定线结构在高电流大面积芯片中广泛采用。
为了有效缓解绑定落点的热应力,多样化的绑定线布局方式可用于降低芯片温度。ABB公司提出了一种多落点绑定线结构,它与传统布线之间的对比如图所示。
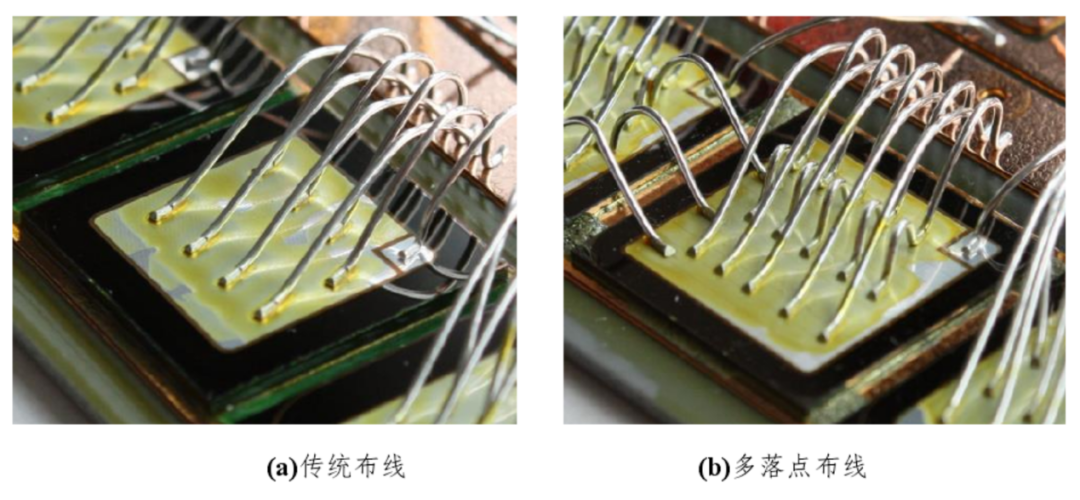
根据对IGBT模块芯片不同布局方式来进行热力学仿真分析发现,IGBT芯片在不同布局方式下,散热情况存在差异:
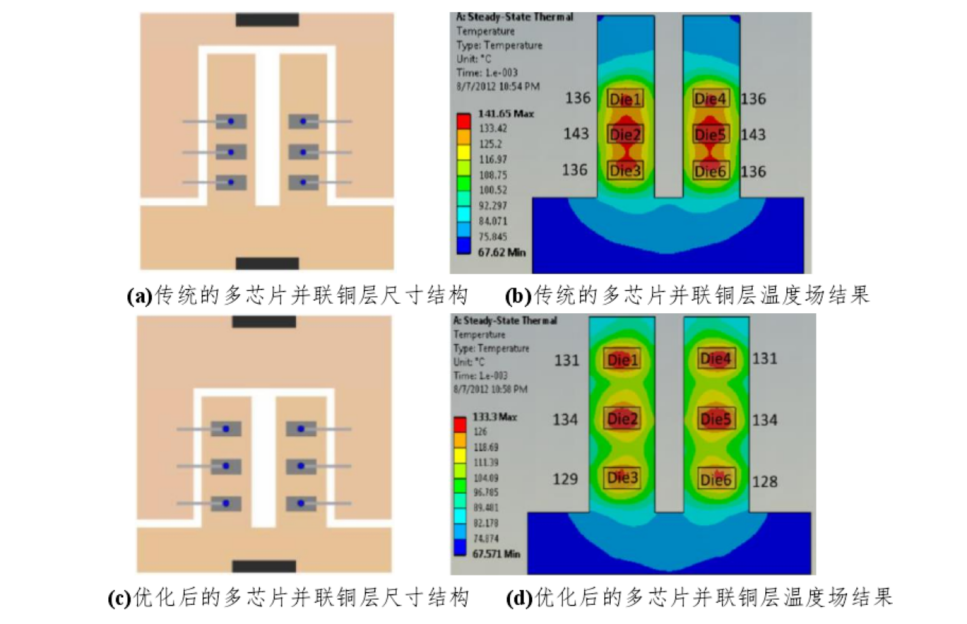
因此,国内外学者在电控功率模块封装布局热优化上进行了初步实践。针对多芯片并联结构调整芯片的位置,使其离射极电极位置更近,芯片布置从部分交错式改为水平对齐式,从而使芯片支路电流不均衡度从50%降低到33%。
的设计,布局设计自由度有回路数量、芯片布局范式、DBC尺寸、绑定布线范式、绑定DBC落点位置、开尔文布线、射极电极位置等。下图是不同公司IGBT模块芯片布局方式:

通过汇总了各模块的封装布局特征,归纳可知绑定线含并排式、交错式、叠层式,多芯片布局含部分交错式、连续交错式、水平对齐式、竖直对齐式等。
其中图(g)(h)采用多芯片布局采用双回路结构。图(d)多芯片间采用了串联式开尔文布线结构。图(g)射极电极设立在芯片1之下。

通过对IGBT芯片布局的优化,可大大降低芯片支电流,降低单芯片发热量,下图是将3片芯片布局方式来进行优化后,芯片支路电流的变化。
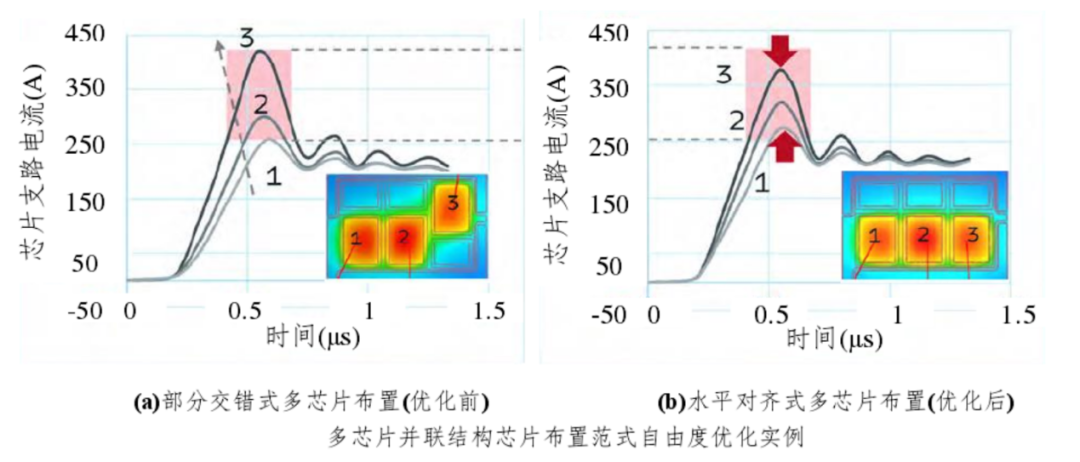
芯片制造技术功率器件IGBT模块芯片生产流程长,工艺复杂,细节较多,但整理工艺流程如下图所示:
根据对IGBT芯片内部结构设计的不同,又可分为PT型、NPT型、FS型,如下图所示:
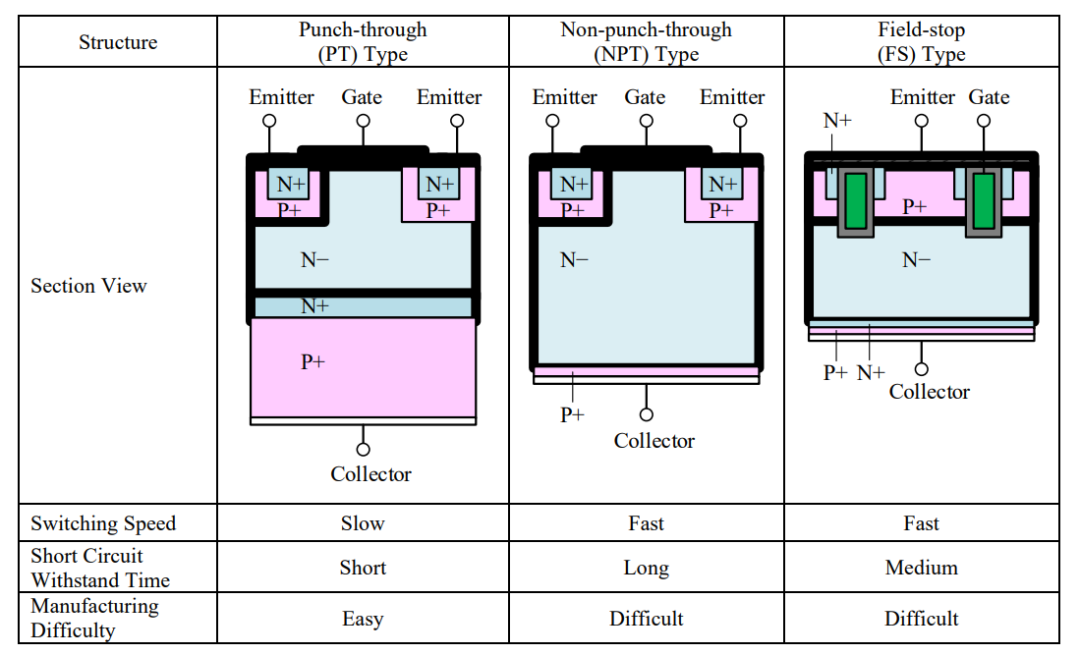
目前报道的Si IGBT最高耐压是8.4kV,并且已经很接近Si器件的极限。同时,工作频率和结温也是限制Si IGBT的重要的因素之一。
电力传输系统等超高压应用领域具有广泛的应用潜力。SiC于1823年在斯德哥尔摩karolinska大学的化学实验室中被Jons Berzelius教授发现。1987年,美国CREE报导了其制造的6H-SiC单晶,宣布SiC郑重进入了一个快速地发展的时代,CREE也成为全世界第一家制造和销售SiC晶片和器件的公司。
(Gate Turn-off Thyristor,GTO)为双极型器件,适用于10kV以上高压范围。2006年发布了世界首款SiC商业化开关器件JFET器件。2008年分别发布了首款SiC BJT器件和常关型的SiC JFET。但MOSFET器件的产品化长期处在空白之中。随着工艺技术的发展尤其是栅氧界面处理技术的成熟,2010年Cree和Rohm推出了平面栅MOSFET产品。
下表中列出了几种常见半导体的材料特性,从中能够准确的看出4H-SiC的禁带宽度是Si的约3倍,同一温度下SiC拥有更低的本征载流子浓度;临界电场约10倍,使SiC可以耐受更高的电压;饱和漂移速度约2倍,使SiC器件具有高速、高频的特性优势;热导率约3倍,使SiC器件可以在更高的温度下工作,减小散热系统体积从而减小整机体积。
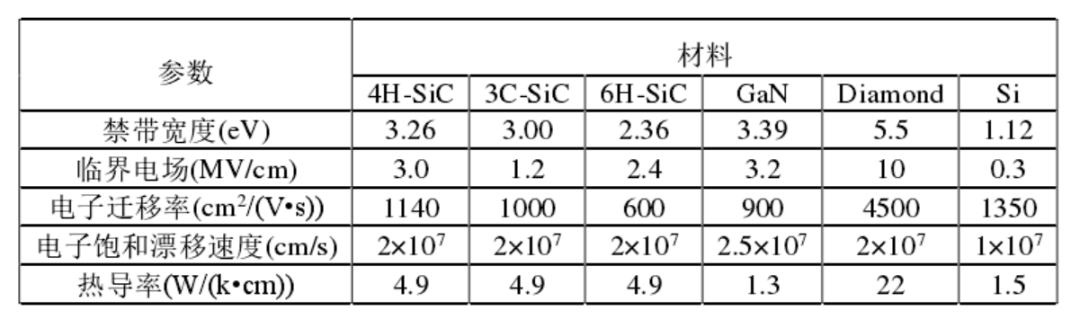
同时,虽然SiC是化合物半导体材料,但是仍旧能在其上通过热氧化的方法形成二氧化硅(SiO2)层,这对于制造SiC栅控型器件非常有利。以上种种优势使得SiC和
(GalliumNitride,GaN)、金刚石材料(Diamond)一起被誉为发展前途十分广阔的第三代半导体材料。得益于SiC优良的材料特性,SiC IGBT在超高压(≥15kV)应用领域具有无法替代的地位,例如电力传输、电力存储、超高压电网
等超高压电力传输系统,以及舰船全电推进系统中的电能管理系统、全电推动航天器。目前,SiC IGBT慢慢的变成了各国半导体研究工作的重点。
碳化硅MOSFET是目前碳化硅器件中最受关注的开关型器件,主要功率器件的企业(Cree、ST、Rohm、Infineon等)都推出了相关的产品。每代产品都在元胞设计、导通压降以及
电压方面慢慢的提升。其中Cree和ST专注于平面栅MOSFET的开发,Rohm公司推出了第一代和第二代平面栅MOSFET之后推出了第三代的沟槽栅MOSFET,亦采用了沟槽栅MOSFET。MOSFET器件的发展的新趋势就是更小的比导通电阻。随着材料生长和工艺的逐步成熟,SiC逐步应用于垂直功率器件。然而早期由于受到SiC离子注入工艺水平的制约,研究人员采用外延掺杂的方式来生长MOSFET的N+区和P阱区。由于沟槽型MOSFET工艺较为简单,1993年该工艺成为最先被用于研制SiC MOSFET器件。
由于沟槽型MOSFET耐压较低,并且随着离子注入和高温退火激活工艺的不断成熟,研究重点又从沟槽型MOSFET变为平面栅双注入MOSFET(DMOSFET)。
传统N沟道穿通型SiC IGBT器件的元胞结构如下图所示,其中(a)是平面型结构, (b)是沟槽型结构。
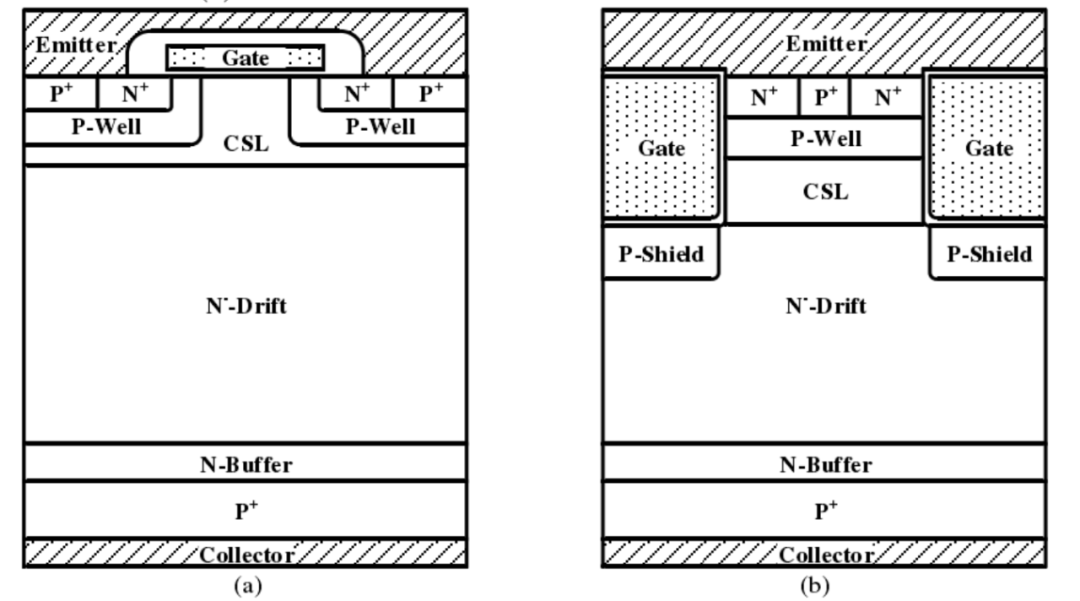
在芯片制造时,碳化硅材料中N型离子注入工艺,常见掺杂离子包括氮离子(N)和磷离子(P)。针对碳化硅材料中P型离子注入,常见的掺杂离子包括铝离子(Al)和硼离子(B)。
离子注入工艺后,注入区域产生大量的缺陷,且掺杂离子大部分处于原子间隙位置,未能产生有效地激活,因而需要退火工艺对缺陷进行修复。
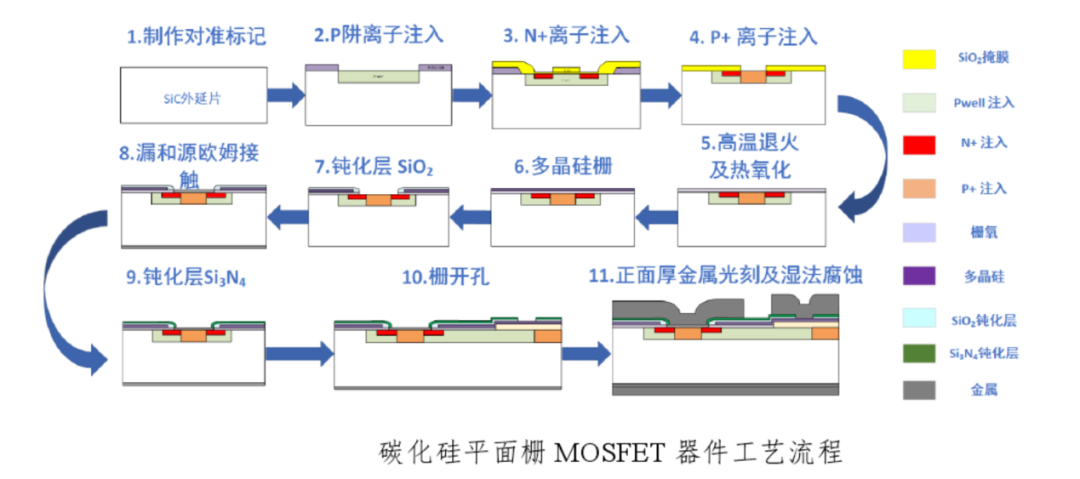
第一个工序需要在外延片上进行对准标记的制作,且需要用该对准标记与后面的图形进行对准。第二至第四个工序,都需要离子注入工艺。离子注入工艺决定了结的形貌和相互关系,在平面栅MOSFET中尤其重要。
SiC是宽禁带半导体材料,相比Si而言具有更大的禁带宽度,更高的临界击穿场强和热导率等优异的材料特性。因此在相同条件下,SiC电力电子器件具有更高的阻断电压,更大的输出功率、更高的工作频率以及更好的温度特性等优势。
随着SiC MOSFET器件逐步使用,对其技术性能的要求慢慢的升高,其中器件的可靠性成为关注重点。从平面栅和沟槽栅的对比来看,平面栅MOSFET由于不存在栅槽,因此其可靠性相对优异。在市场上,平面栅MOSFET已逐步进入市场,甚至部分进入了电动车领域,而沟槽栅MOSFET正在进行可靠性的测试。
如今使用碳化硅MOSFET体二极管作为续流二极管的场合慢慢的变多,而其体二极管由于为PN二极管,因此其开启电压较高,会带来较高的导通损耗。同时PN二极管也会在高温使用场景中带来较大的反向恢复电荷,导致整机应用的效率降低。
总的来说,在新能源汽车应用越来越成熟的情况下,IGBT的功能及材料的提升也将得到快速发展。
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
、GaN材料,由于具有宽带隙、高饱和漂移速度、高临界击穿电场等突出优点,与刚石等
电机驱动市场特别是家电市场对系统的能效、尺寸和稳健性的要求慢慢的升高。为满足市场需求,意法
规格书中的规格值的比较,Eon为开关导通损耗,Eoff为开关关断损耗、Err为恢复损耗。全
元件来适应略微增加的开关频率,但由于无功能量循环而增加传导损耗[2]。因此,开关模式电源一直是向更高效率和高
器件导论免费下载 /
短路时的损耗 /
短路结温和次数 /
AMD自适应计算加速平台之GTYP收发器误码率测试IBERT实验(6)
【Longan Pi 3H 开发板试用连载体验】给ChatGPT装上眼睛,并且还可以语音对线,系统基础配置
【Longan Pi 3H 开发板试用连载体验】给ChatGPT装上眼睛,还可以语音对线 阅读
飞凌嵌入式ElfBoard ELF 1板卡- 减少uboot阶段的等待时间
各位老师,请教《模电》问题: 为啥说“分母s的一次项系数大于0时,电路才能稳定工作”


